台湾のTSMCが日本に先端パッケージ施設を建設する可能性を探っているとReutersが報じている。同社は日本でのチップ生産を開始するが、それに伴う先端パッケージング施設の建設はTSMCにとって自然な動きとも言える。もし同社がこの計画を進めれば、日本の半導体産業再生の取り組みを大きく後押しすることになるだろう。
TSMCが導入を検討しているパッケージングテクノロジーは、同社の最先端技術である「chip-on-wafer-on-substrate-series(CoWoS)」と呼ばれる物だ。CoWoSは、Appleのデスクトップ・ワークステーション向けM2 Ultra、AMDのAI・HPC向けInstinct MI-300プロセッサー、NVIDIAのAI・高性能コンピューティング向けH100 GPUなど、高性能プロセッサーの製造に使用されている。現在、TSMCのCoWoS製造設備はすべて台湾にあるが、日本にもCoWoS製造設備が追加される可能性がある。
この協議は初期段階にあり、投資規模やスケジュールについて明確な決定は下していないという。TSMCはReutersに対し、日本での計画についてコメントを避けたが、CoWoS生産能力の増強はTSMCの一般的な戦略に沿ったものだろう。
日本におけるTSMCの影響力はすでに大きくなっている。1つの工場が建設され、設備が整い、九州に更なる工場を建設する計画も伝えられている。Sonyやトヨタといった日本企業との提携も続き、日本でのベンチャー企業への投資総額は200億ドルを超える見込みだ。
日本での事業拡大の可能性に加え、TSMCは台湾でも先端パッケージング能力を増強している。同社は最近、急増する市場需要に対応するため、台湾南部の嘉義で生産能力を増強する計画を明らかにした。嘉義におけるCoWoS新工場の建設は5月初旬に開始される予定である。
先端半導体パッケージに対する世界的な需要は、主にNVIDIAのH100を中心とするAIプロセッサーの急成長によって、大幅に増加している。これを受け、TSMCは年内にCoWoS生産量を倍増する計画を発表しており、2025年にはさらなる拡大を見込んでいる。
一般的に、台湾での継続的な拡大や日本での協力関係とともに、TSMCが日本で高度なパッケージング能力を構築する可能性があることは、高度なチップ生産とパッケージングに対する世界的な需要の増加に対応するための同社の積極的なアプローチを浮き彫りにしている。
Sources



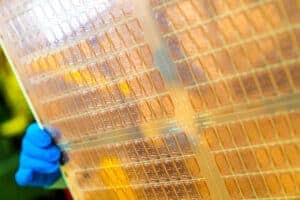




コメントを残す